教授 白石 賢二 (Kenji Shiraishi) (未来材料・システム研究所)
業績リスト
研究内容
※をクリックすると詳細内容が表示されます。
GaN中のらせん転位と不純物の複合体の理論的研究
GaNはデバイス特性に優れた次世代パワー半導体材料として、期待を集めている。GaN自立基板上縦型p-nダイオードにおいて、逆バイアス印加により検出されるリークスポットはらせん転位の位置に一致することが分かっている。本研究では、Mg不純物とらせん転位との複合体における電子構造を第一原理計算で解析し、リーク電流との関係を明らかにした。
計算結果は、Mg原子が転位芯に近づくほど安定化することを示した。これは、らせん転位はMg不純物を引き付ける傾向を持つことを意味する。転位芯からのMg原子の距離が離れた系に対して電子構造を解析したところ、Mg原子が転位芯に近づくにつれ、Highest occupied levelが伝導帯の下端に向けて上昇することが明らかになった。これらの結果から、らせん転位の周りにMg不純物が凝集し、Mgとらせん転位との複合体が形成されると、らせん転位とMg不純物の複合体はドナーとして振る舞い、リーク電流の原因になることが示された。
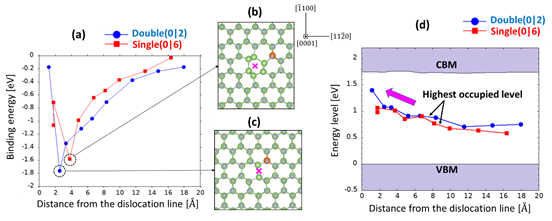
GaNの結晶成長過程の原子レベルでの解析
GaNのMOVPE法は青色発光ダイオードの作製等に用いられており、パワーデバイスや深紫外光デバイスへの応用に向け活発な研究がなされている。MOVPE成長は、水素(H2)または窒素(N2)キャリアガスにより原料ガスであるトリメチルガリウム(TMGa,(CH3)3Ga: TMG)とアンモニア(NH3)を表面温度1300Kの基板に供給する。しかし、TMG分解の詳細な過程は未だ解明されていない。 そこで、原料ガスであるTMGとNH3に加えてH2も含めた分解反応の活性化自由エネルギーをab initio計算によって求めることにより、TMG分解反応の主反応経路についての詳細な理論的考察を行った。
その結果、TMGにH2およびNH3が反応したときの分解反応を考えると下図のようになる。この分解反応にはNH2やHなど明らかに不安定な分子および原子が発生しないように選んでいる。計算した活性化自由エネルギーを用いて、反応速度を計算すると図1で示した赤色の矢印のように、NH3 とH2が交互に反応する経路が最も反応速度が速い経路になることがわかった。これはTMGがNH3と反応しアミノ基が形成されても、すぐにH2によって分解されることを示している。また、GaCH3やGaHは活性化自由エネルギーが高くなるため生成されにくく、最終的にはGaH3が形成されてこれがGaN表面に取りこまれることが明らかとなった。

エネルギーハーベスティング技術の理論的研究
周囲のエネルギーを電力に変換して発電するエネルギーハーベスティング技術が多くの研究者・技術者によって盛んに研究されてされている。エネルギーハーベスティング技術の中でも、カリウムイオンエレクトレットを用いた振動型MEMS発電デバイスはその高い性能から大きな期待を集めている(図1)。カリウムイオンエレクトレットは半永久的に負電荷を保持する材料であり、カリウムを含んだa-SiO2を電圧処理しカリウムイオンを除去することで得られる。しかしカリウムイオンエレクトレットにおける負電荷蓄積機構・保持機構は未だ解明されていない。本研究ではカリウムイオンエレクトレットの負電荷蓄積機構・保持機構の理論的解明を行った。
第一原理計算による解析の結果、通常のa-SiO2中のSiは4配位構造を取る野に対し、カリウムイオンエレクトレットで用いられるa-SiO2中には5つの酸素と結合を持つ5配位のSiO5構造が存在することを明らかにした(図2)。SiO5構造では、Siは+4価になっているのに対し、酸素原子は-2価になっている。Oは2つのSiとボンドを形成するのでSi原子1個あたりの価数は-1である。つまり、SiO5構造は全体として-1価に帯電し、カリウムイオンエレクトレットの負電荷蓄積の起源となる。Si-O結合は非常に強い結合であるため、このSiO5構造構造は堅固な構造である。従って、カリウムイオンエレクトレットの負電荷保持能力は高く、これを用いた振動型MEMS発電デバイスは長寿命となることが期待できる。
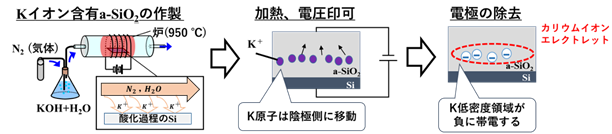

NAND型フラッシュメモリの動作機構の微視的解明
現在のNAND型フラッシュメモリは、MONOS型メモリを基本構成要素としており、MONOS型メモリの中のSiN層中のN空孔に電荷の注入除去を行うことでメモリ動作している。我々は不揮発性メモリを高信頼性で動作させるには書込み消去サイクルにおいて可逆的な構造変化が起きることが不可欠であるという指針を世界に先駆けて提案した(図1)。また我々は、MONOS型メモリはN空孔への電荷の出し入れで動作させれば、書込み消去サイクルにおいて可逆的構造変化することを示した(図2)。
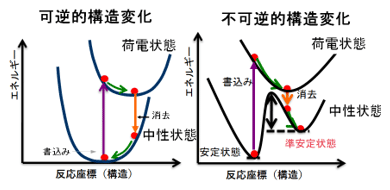
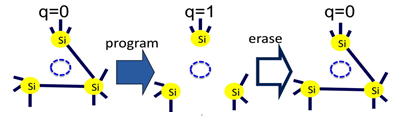
SiCのエピタキシャル成長の原子レベルでの考察
SiC は低エネルギー損失かつ高耐圧なパワーMOSFET の実現が可能なため、長年に渡り研究開発が行われており、既に電車のインバーターなどでは実用化がなされている。非常に優れた性能を示すSiCMOSFET ではあるが、その製造コストは従来のSi MOSFET と比べると高価であり、広範囲のアプリケーション応用へのネックとなっている。より安価なSiC MOSFET 作成に向けて高速かつ大口径な結晶成長を実現することが必要であり、実験による様々な検証がなされている。しかし、結晶成長時の表面構造や表面反応など、詳細な結晶成長機構は明らかになっていなかった。そこで本研究では、SiC 結晶成長機構の解明による結晶成長技術の向上を目指し、第一原理計算と熱力学解析を用いて結晶成長時に現れる表面構造の予測を行った。SiC の表面構造としてSi 原子やH 原子により終端された構造が知られており、特にSi 終端構造は表面の処理条件により様々な被覆率の構造が存在すると報告されている。そこで4H-SiC の(0001) 面,(000-1)面,(1-100) 面に対して、Si またはH 原子による終端構造を複数作成しその安定性を比較し、任意のガス分圧- 温度環境下において最安定な構造を決定した。全ての面において、低温ではH 終端構造またはSiの被覆率が高い構造が安定であるが、高温になるにつれ被覆率の低いSi 終端構造が安定となる。さらに温度が上昇するとSi 原子が脱離し理想表面が現れるが、その温度は各面で異なり、(1-100) 面が最も低く、(000-1) 面で最も高くなる。2000°を超える高温で(000-1) 面上に成長を行うことで成長速度を向上させる手法が開発されており、これは(000-1) 面が高温までSi 終端構造を保持できることが要因となっていると考えられる。
